Partneři Projektu CAD
Nejbližší akce
- 20.04. Trimble SketchUp – základní kurz
- 21.04. Blender – úvod do 3D
- 21.04. Kurz: GD&T a výkresová dokumentace
- 22.04. AutoCAD a AutoCAD LT – základní kurz
- 24.04. Autodesk Maya – pokročilé techniky modelování
- 27.04. Autodesk Maya – úvod do 3D
- 28.04. Autodesk Inventor – kurz iLogic
- 29.04. AutoCAD – kurz pro středně pokročilé
- 30.04. workshop Strukturální mechanika v programu COMSOL Multiphysics
- 04.05. AutoCAD a AutoCAD LT – základní kurz
Aktuální články
- HP Multi Jet Fusion 1200 – průmyslový 3D tisk MJF v kompaktním formátu
- MapFactor Navigator 8.1 pro Android přesnější pro kamiony
- Mapy jsou pro každého 2026
- Nové vlajkové modely monitorů BenQ pro práci s Macy
- Epson uvádí řadu špičkových 6osých robotů CX-A
- Nominace na ocenění MAPA ROKU 2025 vyhlášeny
- Firmy se bojí zaspat, robotizaci si pořizují s předstihem
- Poslední volná místa na Designcenter NX User Event
IBM posouvá Mooreův zákon do 3D |
| Úterý, 24 Duben 2007 13:54 |
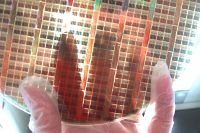 IBM přišlo s průlomovou technologií stohování čipů ve výrobním prostředí, která připravuje podmínky pro trojrozměrné čipy. Ty by měly rozšířit platnost Mooreova zákona za jeho očekávané meze. Technologie zvaná "through-silicon vias" (průchody skrz křemík) umožňuje mnohem těsněji směstnat různé komponenty čipů a vyrábět tak rychlejší, menší a energeticky úspornější systémy.
Objev IBM umožňuje přejít od horizontálního 2D řešení čipů na 3D stohování čipů. Čipy a paměťová zařízení, která bývají tradičně umístěna vedle sebe na křemíkovém plátku, mají být u nové konstrukce čipů umístěna nad sebou. Výsledkem je kompaktní "sendvič" součástek, který je podstatně menší než plošné 2D čipy, a v němž data proudí podstatně rychleji. IBM přišlo s průlomovou technologií stohování čipů ve výrobním prostředí, která připravuje podmínky pro trojrozměrné čipy. Ty by měly rozšířit platnost Mooreova zákona za jeho očekávané meze. Technologie zvaná "through-silicon vias" (průchody skrz křemík) umožňuje mnohem těsněji směstnat různé komponenty čipů a vyrábět tak rychlejší, menší a energeticky úspornější systémy.
Objev IBM umožňuje přejít od horizontálního 2D řešení čipů na 3D stohování čipů. Čipy a paměťová zařízení, která bývají tradičně umístěna vedle sebe na křemíkovém plátku, mají být u nové konstrukce čipů umístěna nad sebou. Výsledkem je kompaktní "sendvič" součástek, který je podstatně menší než plošné 2D čipy, a v němž data proudí podstatně rychleji. Nová metoda odstraňuje delší kovové vodiče propojující součástky dnešních 2D čipů, a místo nich spoléhá na průchody skrz křemík, což jsou v podstatě vertikální spoje vyleptané skrz křemíkový plátek a vyplněné kovem. Tyto průchody umožňují stohovat několik čipů nad sebou, takže je možné mezi čipy přenášet větší objemy informací. Technika tisícinásobně zkracuje vzdálenost, kterou musí překonat informace v čipu, a v porovnání s 2D čipy umožňuje přidat až 100krát víc kanálů pro přenosy informací. První výrobní linka už produkuje čipy s technologií průchodů skrz křemík. Vzorové čipy zpřístupní IBM zákazníkům v druhém pololetí roku 2007, a v roce 2008 zahájí běžnou výrobu. Prvním uplatněním technologie budou bezdrátové komunikační čipy určené do výkonových zesilovačů pro bezdrátové sítě LAN a pro celulární sítě. 3D technologie se uplatní u široké řady čipů včetně těch, které dnes pracují ve vysoce výkonných serverech a superpočítačích IBM. |











